服务热线: 0755-83261303
邮箱:ht@htsemi.com
地址:深圳市龙华区大浪街道浪口社区华昌路315号华昌工业园
GaN氮化镓的4种封装解决方案
 发表时间:2023-11-21
发表时间:2023-11-21 浏览量: 1005
浏览量: 1005
GaN氮化镓晶圆硬度强、镀层硬、材质脆材质特点,与硅晶圆相比在封装过程中对温度、封装应力更为敏感,芯片裂纹、界面分层是封装过程最易出现的问题。同时,GaN产品的高压特性,也在封装设计过程对爬电距离的设计要求也与硅基IC有明显的差异。
因此,对于氮化镓产品的封装,主要有4种封装解决方案。
1. 晶体管封装,在其设计中包含一个或多个HEMT(High electron mobility transistor);
2. 系统级封装(SiP),同一包封体中封装不同功能的芯片;
3. 系统芯片封装(SoC),将不同功能芯片通过晶圆级重构,在性能上更加突出;
4. 模块化封装,将多个功率封装个体集成在一个模块包中。
常见的封装类型如下:
TO类封装:

△图1:晶体管类封装。
表面贴装类封装:

△图2:QFN、PQFN封装。
基板类封装:
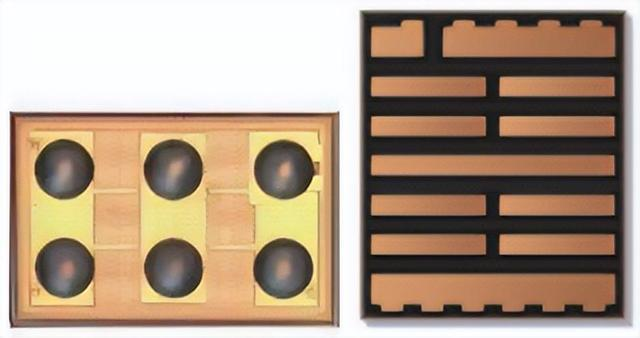
△图3:LGA、BGA封装。
嵌入式封装:
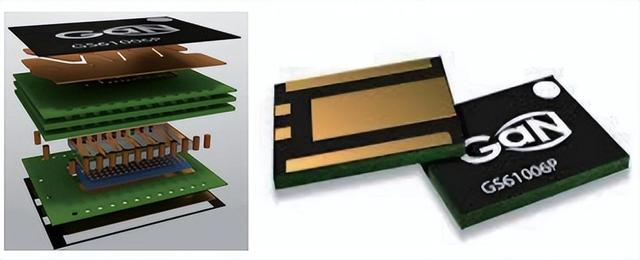
△图4:GaN PXTM嵌入式封装。
从晶圆材质上,目前用于GaN外延生长的衬底材料主要有Si、蓝宝石、SiC、Zn和GaN,其中Si、蓝宝石、SiC三种相对多些,尤其是Si具有成本优势应用最广泛。尽管GaN与Si材料之间的晶格失配和热失配使得在Si衬底上外延生长高质量的GaN材料及其异质结比较困难,但通过运用AlGaN缓冲层、AlGaN/GaN或AlN/GaN等超晶结构和低温AlN插入层等技术,已经能较为有效地控制由晶格及热失配带来的外延层中出现的如位错、裂化、晶圆翘曲等问题(说明对温度比较敏感)。
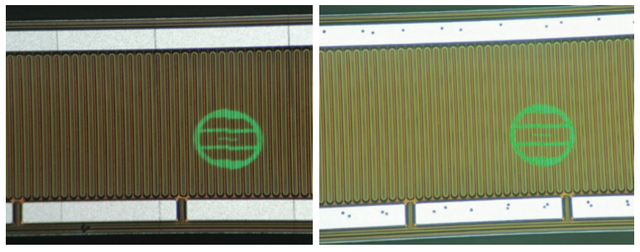
△图5:氮化镓封装产品芯片裂纹示意图(左图:Crack,右图:Normal)。
芯片裂纹是氮化镓产品封装最常见的失效现象,如何快速、准确的识别剔除异常产品,是提高产品封测良率、保障产品正常使用的保障。

△图6:HT-tech 氮化镓封装可靠性例行监控扫描图。
封装过程是集成电路质量的核心管控要素之一,针对氮化镓芯片材质特征,金誉半导体对封装各环节进行工艺方案及设备参数的验证,管控产品研磨过程生产厚度、晶圆切割过程刀具规格以及进刀参数、封装材料CTE性能选择、胶层涂覆厚度、粘接材料烘烤时间及温度等措施,均是避免氮化镓产品质量问题的核心。